sip封装工艺,sip封装有哪几种-KIA MOS管
信息来源:本站 日期:2025-06-27
系统级封装SiP(Single In-line Package)是一种单列直插式集成电路封装技术,其引脚从封装单侧引出并呈直线排列,装配至印刷电路板时呈侧立状态。该封装标准引脚中心距为2.54mm,引脚数量范围通常在2至23个之间,多为定制化产品。
sip封装是将多个具有不同功能的有源电子元件与可选无源器件,以及诸如MEMS或者光学器件等其他器件优先组装到一起,实现一定功能的单个标准封装件,形成一个系统或者子系统。
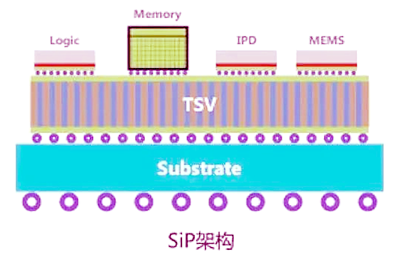
SiP封装类型
从目前业界SiP的设计类型和结构区分,SiP可分为三类:2D SiP、 堆叠SiP和3D SiP。
2D SiP封装:是在同一个封装基板上将芯片一个挨一个的排列以二维的模式封装在一个封装体内。
堆叠SiP封装:是在一个封装中采用物理的方法将两个或多个芯片堆叠整合起来进行封装。
3D SiP封装:是在2D封装的基础上,把多个罗芯片、封装芯片、多芯片甚至圆片进行叠层互联,构成立体封装,这种结构也称作叠层型3D封装。
sip封装核心工艺包括晶圆减薄、芯片贴装、互连形成和封装体构建等步骤。
主要工艺步骤
1.晶圆准备与减薄
原始晶圆厚度约700pm,需研磨至200pm以下,叠层存储芯片需减薄至50pm。3·流程包括贴膜保护、背面研磨和清洗,防止芯片损伤。
2.芯片贴装(Die Attach)
使用银胶(环氧树脂+银粉)粘接芯片与基板,需控制温度(120°℃)和压力以确保牢固性。
关键设备包括固晶机、Pick up head等。
3.互连技术
引线键合(Wire Bonding):传统金/铜线连接方式。
倒装焊(Flip Chip):通过凸点直接连接芯片与基板,密度更高。
4.封装体构建。
包括锡膏印刷、回流焊、清洗及最终包封保护。
SiP封装制程根据芯片与基板的连接方式,可分为引线键合封装和倒装焊两种主要类型。
引线键合封装工艺流程:

联系方式:邹先生
座机:0755-83888366-8022
手机:18123972950(微信同号)
QQ:2880195519
联系地址:深圳市龙华区英泰科汇广场2栋1902
搜索微信公众号:“KIA半导体”或扫码关注官方微信公众号
关注官方微信公众号:提供 MOS管 技术支持
免责声明:网站部分图文来源其它出处,如有侵权请联系删除。
